
推算MO(y)参数的测量作为电路设计方法,普遍采用y参数的方法。特别是由于场效应晶体管的输入阻抗高,容易满足输入输出短路的测量条件,可以说这种设计方法是很恰当的。下述仪器适合于测量Y参数。(i)通用无线电,通用无线电(General Radio)公司的1607-A型转移函数和导纳阻抗电桥(TI仪)这是利用可调长度同轴线能测量h、g、y和z参数的电桥,曾广泛用于衡量晶体管的好坏,但在1970年就停止
推算MO(y)参数的测量作为电路设计方法,普遍采用y参数的方法。特别是由于场效应晶体管的输入阻抗高,容易满足输入输出短路的测量条件,可以说这种设计方法是很恰当的。下述仪器适合于测量Y参数。(i)通用无线电,通用无线电(General Radio)公司的1607-A型转移函数和导纳阻抗电桥(TI仪)这是利用可调长度同轴线能测量h、g、y和z参数的电桥,曾广泛用于衡量晶体管的好坏,但在1970年就停止
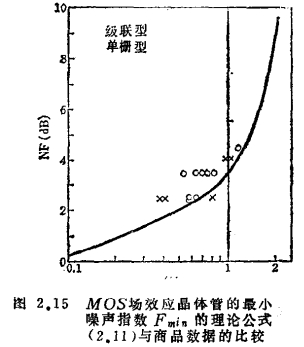
MOS管结构高频的高频特性正在逐年提高,它的实用频率已扩展到甚高频乃至超高频段。一般说来,场效应晶体管与双极型晶体管相比,在高频方面具有非线性小,大信号特性良好的特点。而MOS型场效应晶体管与结型场效应晶体管相比,结型管沟道中多数载流子的迁移率高,而MOS型结构简单,有利于微型化。MOS管结构高频。对单栅型而言,两类场效应晶体管的高频特性可以说没有多大差别1),但在结构复杂的级联型方面,MOS型的
MOS管结构高频的高频特性正在逐年提高,它的实用频率已扩展到甚高频乃至超高频段。一般说来,场效应晶体管与双极型晶体管相比,在高频方面具有非线性小,大信号特性良好的特点。而MOS型场效应晶体管与结型场效应晶体管相比,结型管沟道中多数载流子的迁移率高,而MOS型结构简单,有利于微型化。MOS管结构高频。对单栅型而言,两类场效应晶体管的高频特性可以说没有多大差别1),但在结构复杂的级联型方面,MOS型的

电荷传输,电荷传输现象的分析,考虑MOS二极管I下面积累着衬底的少数载流子——空穴,在与之相邻的MOS二极管Ⅱ上加一传输电荷用的脉冲,使空穴由MOS二极管I向Ⅱ传输的情形。由于在MOS二极管I上加上了供电荷传输用的脉冲,MOS二极管I下面的反型层内几乎不产生指向MOS二极管Ⅱ的电场,而是可等效地说,MOS二极管I下面积累空穴的势阱壁在与MOS二极管Ⅱ邻接的部分相应地降低了。所以,空穴传输的原动力是
电荷传输,电荷传输现象的分析,考虑MOS二极管I下面积累着衬底的少数载流子——空穴,在与之相邻的MOS二极管Ⅱ上加一传输电荷用的脉冲,使空穴由MOS二极管I向Ⅱ传输的情形。由于在MOS二极管I上加上了供电荷传输用的脉冲,MOS二极管I下面的反型层内几乎不产生指向MOS二极管Ⅱ的电场,而是可等效地说,MOS二极管I下面积累空穴的势阱壁在与MOS二极管Ⅱ邻接的部分相应地降低了。所以,空穴传输的原动力是

电荷耦合器件,今有图1.21所示的两个紧邻的MOS二极管。假设在电极1的下面积累了用某种方法注入的空穴,形成反型层。又假设在电极2上加一电压,选择其极性使电极2下面形成耗尽层,或形成积累层。并假设于某一时刻加一个可形成反型层的某极性的大电压。两个MOS二极管十分接近,使MOS二极管2的耗尽层到达MOS二极管1的反型层,此时MOS二极管1中的少数载流子就转移到MOS二极管2中去。从而如制造互相接近的
电荷耦合器件,今有图1.21所示的两个紧邻的MOS二极管。假设在电极1的下面积累了用某种方法注入的空穴,形成反型层。又假设在电极2上加一电压,选择其极性使电极2下面形成耗尽层,或形成积累层。并假设于某一时刻加一个可形成反型层的某极性的大电压。两个MOS二极管十分接近,使MOS二极管2的耗尽层到达MOS二极管1的反型层,此时MOS二极管1中的少数载流子就转移到MOS二极管2中去。从而如制造互相接近的
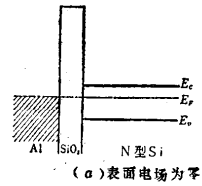
MOS二极管,假定有一个MOS二极管,系在N型硅上生长的二氧化硅膜上蒸发铝等金属构成,如图1.19所示。为简单起见,只称栅电压的时候就是指有效栅电压,栅电压为零就是指硅表面的电场为零,如图1.19(a)所示。如在这个栅上相对于硅衬底加负电压,当所加电压不太大时,在硅表面形成耗尽层,如图1.19(b)所示;若加上更大的负栅电压时,众所周知,在硅表面上形成反型层,如图1.19(c)所示。请注意,这是稳
MOS二极管,假定有一个MOS二极管,系在N型硅上生长的二氧化硅膜上蒸发铝等金属构成,如图1.19所示。为简单起见,只称栅电压的时候就是指有效栅电压,栅电压为零就是指硅表面的电场为零,如图1.19(a)所示。如在这个栅上相对于硅衬底加负电压,当所加电压不太大时,在硅表面形成耗尽层,如图1.19(b)所示;若加上更大的负栅电压时,众所周知,在硅表面上形成反型层,如图1.19(c)所示。请注意,这是稳

MOS场效应晶体管中的噪声,有热噪声和闪变噪声。热噪声在本质上是必然要发生的,闪变噪声从原理上应该说是可以消灭的,但在实际的器件中,闪变噪声或1/f噪声是具有代表性的噪声,在极低频的噪声中起决定性的作用。此处先讨论比较简单的热噪声,再讨论1/f噪声。(1)MOS场效应晶体管热噪声,因沟道内电子的无规热运动而产生热噪声,这个热噪声通过沟道内的电阻生成热噪声电压。当求由此而生成的热噪声电流时,须注
MOS场效应晶体管中的噪声,有热噪声和闪变噪声。热噪声在本质上是必然要发生的,闪变噪声从原理上应该说是可以消灭的,但在实际的器件中,闪变噪声或1/f噪声是具有代表性的噪声,在极低频的噪声中起决定性的作用。此处先讨论比较简单的热噪声,再讨论1/f噪声。(1)MOS场效应晶体管热噪声,因沟道内电子的无规热运动而产生热噪声,这个热噪声通过沟道内的电阻生成热噪声电压。当求由此而生成的热噪声电流时,须注
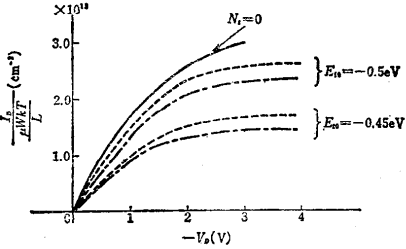
MOS场效应晶体管静态特性的影响,界面俘获中心对MOS场效应晶体管静态特性的影响分析 硅-二氧化硅界面上存在的界面俘态对MOS场效应晶体管静态特性的影响,当界面态有电荷时,该电荷就作为固定电荷包括在Qss之中。1.2节以后就是这样做的。但界面态的电荷与电子被界面态俘获的多寡有关,电荷的数量是在变化的。因而界面态的存在不能用固定界面电荷的存在来替换,同时还要考虑到硅表面势是随栅电压和漏电压而变化的,
MOS场效应晶体管静态特性的影响,界面俘获中心对MOS场效应晶体管静态特性的影响分析 硅-二氧化硅界面上存在的界面俘态对MOS场效应晶体管静态特性的影响,当界面态有电荷时,该电荷就作为固定电荷包括在Qss之中。1.2节以后就是这样做的。但界面态的电荷与电子被界面态俘获的多寡有关,电荷的数量是在变化的。因而界面态的存在不能用固定界面电荷的存在来替换,同时还要考虑到硅表面势是随栅电压和漏电压而变化的,

MOS管电路阈值电压附近的特性解析,沟道电流由夹断状态转变为导通状态的阈值附近的特性,对于后面所讲的互补型MOS电路非常重要,所以在这里略加说明。由式(1.23)可知,如设栅电压在硅表面感生的电荷面密度为Qs(ψs),若忽略衬底所含杂质离子产生的电荷,则有公式分析
MOS管电路阈值电压附近的特性解析,沟道电流由夹断状态转变为导通状态的阈值附近的特性,对于后面所讲的互补型MOS电路非常重要,所以在这里略加说明。由式(1.23)可知,如设栅电压在硅表面感生的电荷面密度为Qs(ψs),若忽略衬底所含杂质离子产生的电荷,则有公式分析

MOS场效晶体管界面处载流子迁移率与漏电压的关系,在低电场下,电子的漂移速度υd与外加电场Ez成正比,可用υd=μEх表示。故电子的漂移迁移率μ为常数,但随着电场强度的增加,电子和声学声子发生非弹性碰撞,结果是电子给予声学声子的能量比例增大,因此,电子的漂移速度虽增加,但不与电场成正比地增加。若进一步增加电场,电子的动能就变得很大,释放出光学声子,电子的漂移速度不再增加。这种现象可在晶体内部,也可
MOS场效晶体管界面处载流子迁移率与漏电压的关系,在低电场下,电子的漂移速度υd与外加电场Ez成正比,可用υd=μEх表示。故电子的漂移迁移率μ为常数,但随着电场强度的增加,电子和声学声子发生非弹性碰撞,结果是电子给予声学声子的能量比例增大,因此,电子的漂移速度虽增加,但不与电场成正比地增加。若进一步增加电场,电子的动能就变得很大,释放出光学声子,电子的漂移速度不再增加。这种现象可在晶体内部,也可

界面处载流子迁移率与栅电压的关系至此,对于沟道内载流子迁移率μch并未过多涉及,而将它视作常数。但沟道内载流子迁移率的值比对大块硅晶体测量的值μB要小,且测得随栅电压和漏电压而变化。μch与栅电压的关系以及μch较晶体体内值为小这两点是紧密联系着的。因此,要对这一问题进行讨论。已经知道,不仅半导体表面反型层内载流子的迁移率,而且于薄膜所观测到的迁移率也比大块晶体测得的迁移率要小。可以认为两者共同的
界面处载流子迁移率与栅电压的关系至此,对于沟道内载流子迁移率μch并未过多涉及,而将它视作常数。但沟道内载流子迁移率的值比对大块硅晶体测量的值μB要小,且测得随栅电压和漏电压而变化。μch与栅电压的关系以及μch较晶体体内值为小这两点是紧密联系着的。因此,要对这一问题进行讨论。已经知道,不仅半导体表面反型层内载流子的迁移率,而且于薄膜所观测到的迁移率也比大块晶体测得的迁移率要小。可以认为两者共同的