
MOS场效应管源漏寄生串联电阻的影响随着器件尺寸的缩小,S/D区pn结深度变浅,接触孔面积变小,使源漏区的寄生串联电阻Rs、RD变大。图1.25表示存在Rs、RD情况下器件的电位情况。Rs、RD作为器件的一个寄生元件是采用任何一种测量手段都不可避开的,也是在电路模拟中必须考虑的重要因素。由图可得:先考虑VDS比较小的情况,在线性区有其中θo是不考虑Rs、RD的迁移率修正系数。将(1.61)及(1.
MOS场效应管源漏寄生串联电阻的影响随着器件尺寸的缩小,S/D区pn结深度变浅,接触孔面积变小,使源漏区的寄生串联电阻Rs、RD变大。图1.25表示存在Rs、RD情况下器件的电位情况。Rs、RD作为器件的一个寄生元件是采用任何一种测量手段都不可避开的,也是在电路模拟中必须考虑的重要因素。由图可得:先考虑VDS比较小的情况,在线性区有其中θo是不考虑Rs、RD的迁移率修正系数。将(1.61)及(1.

MOS管饱和区特性及处理短沟器件的有三种方法当VDS增加到足够大时,IDS由线性区进入饱和区。众所周知,大尺寸器件因漏区被夹断达到饱和,β和与无关、进入饱和区的标志为,由对(1.43)式微分而得饱和电压和饱和电流的表达式:实验表明,短沟器件的饱和特性与大尺寸器件有很大的不同,这是因为两者饱和机理不同所致。图1.18和图1.19分别画出它们的输出特性的实测结果。由它们的对比可见,短沟管有如下
MOS管饱和区特性及处理短沟器件的有三种方法当VDS增加到足够大时,IDS由线性区进入饱和区。众所周知,大尺寸器件因漏区被夹断达到饱和,β和与无关、进入饱和区的标志为,由对(1.43)式微分而得饱和电压和饱和电流的表达式:实验表明,短沟器件的饱和特性与大尺寸器件有很大的不同,这是因为两者饱和机理不同所致。图1.18和图1.19分别画出它们的输出特性的实测结果。由它们的对比可见,短沟管有如下
线性区MOS 2模型中的线性区采用类似于MOS 1大尺寸器件公式(即Shichman-Hodges公式),仅对开启电压和有效迁移率进行修正。其表达式为:其中是与窄沟效应有关的系数,为短沟衬偏系数,采用(1.18)公式。由(1.38)式可见,虽然已经作了不少近似和简化,但计算公式仍然很繁。MOS 3线性区的推导方法与MOS 2有所不同。为了公式简化,避免(1.38)式中的3/2次方项带来的计算麻烦,
线性区MOS 2模型中的线性区采用类似于MOS 1大尺寸器件公式(即Shichman-Hodges公式),仅对开启电压和有效迁移率进行修正。其表达式为:其中是与窄沟效应有关的系数,为短沟衬偏系数,采用(1.18)公式。由(1.38)式可见,虽然已经作了不少近似和简化,但计算公式仍然很繁。MOS 3线性区的推导方法与MOS 2有所不同。为了公式简化,避免(1.38)式中的3/2次方项带来的计算麻烦,

表面迁移率的纵向电场效应实验发现,纵向电场(栅电场)的加强会使表面沟道中的载流子迁移率明显下降。其原因是纵向电场把沟道载流子拉向表面,增加它的表面散射几率。对于表面有效迁移率与表面纵向电场的关系有几种近似表达式。SPICE的MOS 1和MOS 2模型中采用如下的近似公式:这是以实验为基础的近似式。其中是低场下的表面迁移率,为临界电场,约为,为在硅中的表面纵向电场。当时,近似不变,其值为;当时,以幂
表面迁移率的纵向电场效应实验发现,纵向电场(栅电场)的加强会使表面沟道中的载流子迁移率明显下降。其原因是纵向电场把沟道载流子拉向表面,增加它的表面散射几率。对于表面有效迁移率与表面纵向电场的关系有几种近似表达式。SPICE的MOS 1和MOS 2模型中采用如下的近似公式:这是以实验为基础的近似式。其中是低场下的表面迁移率,为临界电场,约为,为在硅中的表面纵向电场。当时,近似不变,其值为;当时,以幂

MOS管窄沟效应MOS电路中的负载管,经常有W/L 1的情形。对这类负载管如果W设计得太小,就会出现开启升高的窄沟效应,要引起注意。图1.15是窄沟管的沟宽剖面。引起窄沟效应的原因是比较复杂的,在SPICE程序中仅认为是由于在沟宽方向上的边缘场使耗尽电荷增加所致。它的模型如图1.15所示,但要求解耗尽电荷是个多维泊松方程,比较麻烦。为了便于计算,先把边缘场的影响夸大成四分之一圆形,然后乘以一个拟合
MOS管窄沟效应MOS电路中的负载管,经常有W/L 1的情形。对这类负载管如果W设计得太小,就会出现开启升高的窄沟效应,要引起注意。图1.15是窄沟管的沟宽剖面。引起窄沟效应的原因是比较复杂的,在SPICE程序中仅认为是由于在沟宽方向上的边缘场使耗尽电荷增加所致。它的模型如图1.15所示,但要求解耗尽电荷是个多维泊松方程,比较麻烦。为了便于计算,先把边缘场的影响夸大成四分之一圆形,然后乘以一个拟合
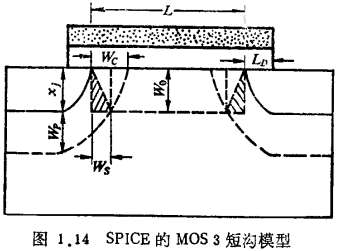
为了适宜小尺寸器件组成的VLSI的电路模拟,在SPICE程序中提供了两种小尺寸器件模型,即MOS 2和MOS 3。它们都是根据电荷共享模型分析短沟效应。MOS 2的短沟模型如图1.13所示。为了便于计算,将源漏pn结的侧向近似为四分之一圆形剖面,其半径就是结深xj。结耗尽区宽度采用平面结近似计算公式。从几何上找出栅耗尽底部与pn结耗尽区的交点c、b,它们与栅长ad形成一个梯形区作为栅压开启的耗尽部
为了适宜小尺寸器件组成的VLSI的电路模拟,在SPICE程序中提供了两种小尺寸器件模型,即MOS 2和MOS 3。它们都是根据电荷共享模型分析短沟效应。MOS 2的短沟模型如图1.13所示。为了便于计算,将源漏pn结的侧向近似为四分之一圆形剖面,其半径就是结深xj。结耗尽区宽度采用平面结近似计算公式。从几何上找出栅耗尽底部与pn结耗尽区的交点c、b,它们与栅长ad形成一个梯形区作为栅压开启的耗尽部
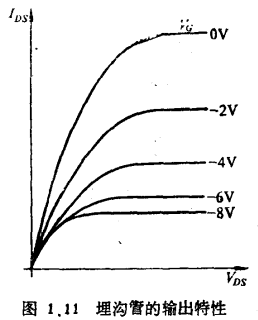
MOS管埋沟型,向沟道区注入与衬底反型的杂质,会在表面下形成一层与源漏区同型的导电沟道及对衬底的pn结,由此得到埋沟导电机理。埋沟管的杂质分布剖面如图1.6所示。注入区补偿衬底杂质后得反型浓度为image.png在深度为image.png点注入杂质与衬底杂质浓度相同,形成pn结。为了计算简单,一般采用“BOX”近似进行分析,当然也可以采用较复杂的、较精确的分布进行计算分析,但在方法上基本是类似的,
MOS管埋沟型,向沟道区注入与衬底反型的杂质,会在表面下形成一层与源漏区同型的导电沟道及对衬底的pn结,由此得到埋沟导电机理。埋沟管的杂质分布剖面如图1.6所示。注入区补偿衬底杂质后得反型浓度为image.png在深度为image.png点注入杂质与衬底杂质浓度相同,形成pn结。为了计算简单,一般采用“BOX”近似进行分析,当然也可以采用较复杂的、较精确的分布进行计算分析,但在方法上基本是类似的,

MOS管表面沟型,沟道区注入杂质与衬底同型,形成杂质浓度在表面附近高、向衬底方向渐减的分布趋势。器件的特性与具体的杂质分布函数有关。用离子注入得到的分布函数与它的注入剂、能量以及后步热处理等条件有关。较大能量的深注入在表面附近形成如图1.2所示的对称高斯分布,其峰值在表面以下。较浅注入的情形,峰值基本上在表面,形成近似单边高斯分布。后步的热处理使峰值附近的变化趋于平缓。综合深、浅注入及后步热处理,
MOS管表面沟型,沟道区注入杂质与衬底同型,形成杂质浓度在表面附近高、向衬底方向渐减的分布趋势。器件的特性与具体的杂质分布函数有关。用离子注入得到的分布函数与它的注入剂、能量以及后步热处理等条件有关。较大能量的深注入在表面附近形成如图1.2所示的对称高斯分布,其峰值在表面以下。较浅注入的情形,峰值基本上在表面,形成近似单边高斯分布。后步的热处理使峰值附近的变化趋于平缓。综合深、浅注入及后步热处理,

解析在VLSI中MOS器件沟道区离子注入作用在VLSI中MOS器件的沟道区需要进行离子注入。一般进行两次注入,即浅注入与深注入。浅注入为了调整开启电压;深注入为了防止源漏之间的穿通(穿通问题将在第二章分析)。因此,栅下的杂质分布不仅决定于衬底掺杂,而且还决定于注入杂质,因而呈不均匀分布。离子注入会影响管子的开启特性,改变开启电压的数值和符号,同时,也影响导电沟道的类型。为了避免概念上的混淆,我们先
解析在VLSI中MOS器件沟道区离子注入作用在VLSI中MOS器件的沟道区需要进行离子注入。一般进行两次注入,即浅注入与深注入。浅注入为了调整开启电压;深注入为了防止源漏之间的穿通(穿通问题将在第二章分析)。因此,栅下的杂质分布不仅决定于衬底掺杂,而且还决定于注入杂质,因而呈不均匀分布。离子注入会影响管子的开启特性,改变开启电压的数值和符号,同时,也影响导电沟道的类型。为了避免概念上的混淆,我们先
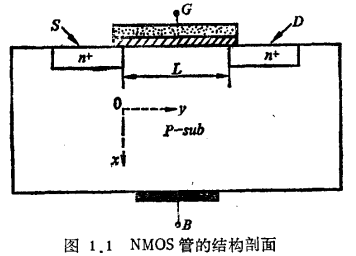
小尺寸MOS器件模型-GCA及其局限性图1.1为一个NMOS管的结构剖面。它是一个四端器件,栅下的沟道区是它的核心。沟道区的载流子受到纵向和横向电场的同时作用,由此形成电流,因此是一个二维问题。如果考虑它在沟道宽度方向的边缘效应,应该是一个三维问题。求解三维泊松方程是十分麻烦的,不可能得到解析解,只能用数值分析方法求解。在长沟大尺寸情况下,问题可以大大简化。由于沟长L比栅介质SiO2的厚度(约10
小尺寸MOS器件模型-GCA及其局限性图1.1为一个NMOS管的结构剖面。它是一个四端器件,栅下的沟道区是它的核心。沟道区的载流子受到纵向和横向电场的同时作用,由此形成电流,因此是一个二维问题。如果考虑它在沟道宽度方向的边缘效应,应该是一个三维问题。求解三维泊松方程是十分麻烦的,不可能得到解析解,只能用数值分析方法求解。在长沟大尺寸情况下,问题可以大大简化。由于沟长L比栅介质SiO2的厚度(约10