
MOS器件尺寸缩小及其限制和典型工艺参量表Scaling-down的基本原理Scaling-down或称等比例缩小,首先在1974年由Dennard提出。其指导思想是在MOS器件内部电场不变的条件下,通过纵、横向尺寸的缩小,以增加跨导和减少级联负载电容,由此可以大大提高电路的性能。同时要求电源电压与尺寸按同样比例下降。这样,使器件与电场有关的非线性因素(如迁移率)也不会因此而改变。这种缩小规律称为
MOS器件尺寸缩小及其限制和典型工艺参量表Scaling-down的基本原理Scaling-down或称等比例缩小,首先在1974年由Dennard提出。其指导思想是在MOS器件内部电场不变的条件下,通过纵、横向尺寸的缩小,以增加跨导和减少级联负载电容,由此可以大大提高电路的性能。同时要求电源电压与尺寸按同样比例下降。这样,使器件与电场有关的非线性因素(如迁移率)也不会因此而改变。这种缩小规律称为

MOS管器件弱反型次开启特性及关系式分析,弱反型次开启早期就有人发现,在长沟MOS器件中IDS随VGS不是突变的,而是有一段缓冲过渡区,如图1.36所示。此过渡区就是弱反型次开启区。它在原理上是不难理解的,因为早先模型中,人为地定义作为开启条件,这是强反型条件。当时表面就开始反型,将称为弱反型区,并有弱反型电流。下面将对弱反型电流进行定量分析。图1.37为弱反型条件下的表面能带图。为沟道电位。
MOS管器件弱反型次开启特性及关系式分析,弱反型次开启早期就有人发现,在长沟MOS器件中IDS随VGS不是突变的,而是有一段缓冲过渡区,如图1.36所示。此过渡区就是弱反型次开启区。它在原理上是不难理解的,因为早先模型中,人为地定义作为开启条件,这是强反型条件。当时表面就开始反型,将称为弱反型区,并有弱反型电流。下面将对弱反型电流进行定量分析。图1.37为弱反型条件下的表面能带图。为沟道电位。
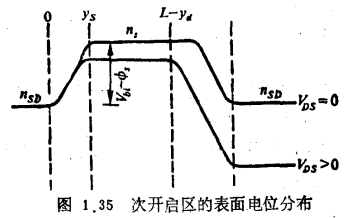
MOS管器件DIBL次开启电流区的表面电位分布分析次开启是指VGS VTB时源漏之间的漏电,这也是VLSI器件研究的重要课题。一方面随着器件尺寸的缩小次开启问题更严重,会对器件性能带来不利影响,例如动态电路中结点电平不能保持;另一方面次开启区有跨导变化大、功耗低、工作电压低等特点可以有效被利用。长沟和短沟器件的次开启机理不同。前者起主要作用的是弱反型次开启,它是指表面已反型,但未达到ΦS=2▏ΦP
MOS管器件DIBL次开启电流区的表面电位分布分析次开启是指VGS VTB时源漏之间的漏电,这也是VLSI器件研究的重要课题。一方面随着器件尺寸的缩小次开启问题更严重,会对器件性能带来不利影响,例如动态电路中结点电平不能保持;另一方面次开启区有跨导变化大、功耗低、工作电压低等特点可以有效被利用。长沟和短沟器件的次开启机理不同。前者起主要作用的是弱反型次开启,它是指表面已反型,但未达到ΦS=2▏ΦP
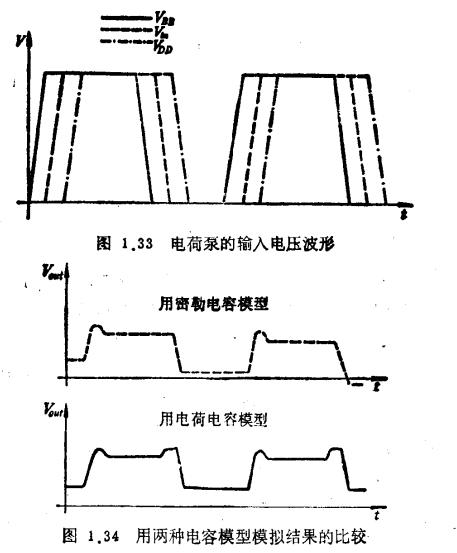
MOS管特征模型举例和比较基础特性详解图1.32是一个电荷泵电路,用它来验查电容模型的工作情况。G、B和D加上如图1.33所示的时间互相叉开的脉冲,进行开关工作,于是在电容C上会充上周期性的电压。我们将密勒模型及电荷电容模型装入SPICE 2中,分别用它们对此电荷泵进行电路模拟计算。模拟结果的比较如图1.34所示。由图可见,用密勒电容模型的计算结果呈衰退趋势, 反映电荷不守恒,用电荷电容模型的结果
MOS管特征模型举例和比较基础特性详解图1.32是一个电荷泵电路,用它来验查电容模型的工作情况。G、B和D加上如图1.33所示的时间互相叉开的脉冲,进行开关工作,于是在电容C上会充上周期性的电压。我们将密勒模型及电荷电容模型装入SPICE 2中,分别用它们对此电荷泵进行电路模拟计算。模拟结果的比较如图1.34所示。由图可见,用密勒电容模型的计算结果呈衰退趋势, 反映电荷不守恒,用电荷电容模型的结果

MOS管电路模拟中电荷模型的组成基础电流与电荷之间的关系为:在进行数值计算时设下标为端点,上标为牛顿迭代次数。采用梯形近似式:进行线姓化,得电流迭代式:将(1.116)式代入上式,得并定义为端点l与m之间的电容k次迭代值。但是,这个电容Clm已失去本身的意义,只是作为展开系数。(1.118)式可简化为:其中(1.120)式代入结点的导纳矩阵可求解,其中应注意电容系数的不可逆性,即这也是与真正电容的
MOS管电路模拟中电荷模型的组成基础电流与电荷之间的关系为:在进行数值计算时设下标为端点,上标为牛顿迭代次数。采用梯形近似式:进行线姓化,得电流迭代式:将(1.116)式代入上式,得并定义为端点l与m之间的电容k次迭代值。但是,这个电容Clm已失去本身的意义,只是作为展开系数。(1.118)式可简化为:其中(1.120)式代入结点的导纳矩阵可求解,其中应注意电容系数的不可逆性,即这也是与真正电容的

MOS管沟道电荷QC的分割公式分析详解MOS管沟道电荷QC的分割QC可以积分求得,如(1.88)和(1.91)式,而要把科学地分割成Qs和QD就比较复杂。为此,采用瞬态分析法。在S端和D端分别有:其中为t时刻仅与r时刻的端电压有关的稳态值。为了求解Qs、QD,列出沟道各点的电流方程:如不考虑复合损失,则有:积分上式:将(1.98)式代入上式:从0到L积分上式:改写上式中的积分:上式代入(1.100
MOS管沟道电荷QC的分割公式分析详解MOS管沟道电荷QC的分割QC可以积分求得,如(1.88)和(1.91)式,而要把科学地分割成Qs和QD就比较复杂。为此,采用瞬态分析法。在S端和D端分别有:其中为t时刻仅与r时刻的端电压有关的稳态值。为了求解Qs、QD,列出沟道各点的电流方程:如不考虑复合损失,则有:积分上式:将(1.98)式代入上式:从0到L积分上式:改写上式中的积分:上式代入(1.100

分析MOS管电荷模型的线性区-饱和区-截止区方式说明实际上,MOS作为四端器件用端电压或端电荷都可以表示它的状态,只是用端电荷QG、QB、QS、QD表示有些不习惯。由上述可知,用Q表示可以保持电荷守恒,但确有不便之处,其原因为QS和QD是沟道总电荷QG分割而得。如何将QG合理分割成QS和QD是个难题,本节第三部分将对此进行专门的分析。MOS管在不同工作区有不同的电荷密度q的表达式:1、线性区其中a
分析MOS管电荷模型的线性区-饱和区-截止区方式说明实际上,MOS作为四端器件用端电压或端电荷都可以表示它的状态,只是用端电荷QG、QB、QS、QD表示有些不习惯。由上述可知,用Q表示可以保持电荷守恒,但确有不便之处,其原因为QS和QD是沟道总电荷QG分割而得。如何将QG合理分割成QS和QD是个难题,本节第三部分将对此进行专门的分析。MOS管在不同工作区有不同的电荷密度q的表达式:1、线性区其中a
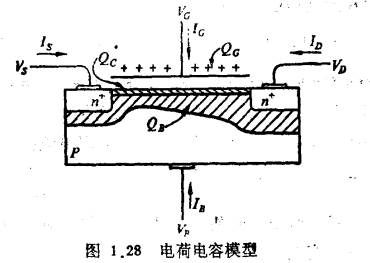
解析MOS管器件电荷不守恒问题的起源原因对电路进行瞬态(或动态)特性分析时,决定性的因素是电流对电容的充放电速度。因此,建立L个比较准确的电容模型是进行电路模拟的基础。MOS器件的电容看起来似乎比较简单, 无非是些平板电容、pn结电容。但实际上由于沟道的存在及多变,使电容的模型相对比较复杂。如果处理不当,就会出现错误,造成计算结果的不合理,特别是电荷不守恒问题。如图1.28所示,MOS器件分成本征
解析MOS管器件电荷不守恒问题的起源原因对电路进行瞬态(或动态)特性分析时,决定性的因素是电流对电容的充放电速度。因此,建立L个比较准确的电容模型是进行电路模拟的基础。MOS器件的电容看起来似乎比较简单, 无非是些平板电容、pn结电容。但实际上由于沟道的存在及多变,使电容的模型相对比较复杂。如果处理不当,就会出现错误,造成计算结果的不合理,特别是电荷不守恒问题。如图1.28所示,MOS器件分成本征
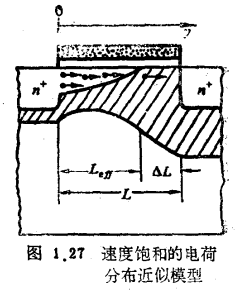
MOS管沟长调制效应饱和的长沟-短沟采取不同近似方法当时,从漏端开始沟道被夹断或速度达饱和 (对短沟器件),有效沟道长度随之减小。VDS越大,越小。正是由于随VDS(大于)的增加而减小,引起输出饱和区特性曲线上翘现象。如图1.19所示,这也是饱和区具有有限输出阻抗的主要原因。由IDS公式可知,,因此沟长调制效应可表示为:其中ΔL就是在条件下引起的有效沟长的缩短量, 是起始饱和点的。由(1.67)式
MOS管沟长调制效应饱和的长沟-短沟采取不同近似方法当时,从漏端开始沟道被夹断或速度达饱和 (对短沟器件),有效沟道长度随之减小。VDS越大,越小。正是由于随VDS(大于)的增加而减小,引起输出饱和区特性曲线上翘现象。如图1.19所示,这也是饱和区具有有限输出阻抗的主要原因。由IDS公式可知,,因此沟长调制效应可表示为:其中ΔL就是在条件下引起的有效沟长的缩短量, 是起始饱和点的。由(1.67)式
MOS管埋沟管在此简单介绍一下埋沟管的IDS计算中的一些问题。由于埋沟管有多种工作状态,情况比表面沟复杂。第二节中已指出,不能以简单地改变开启电压的办法用表面沟公式代替埋沟公式。埋沟管有三种工作状态,即表面反型、表面耗尽和表面积累,而且因为源端和漏端电位不同可以工作在不同的状态,例如可以是源端表面积累而漏端表面耗尽,由此使计算IDS的公式更为复杂。用“BOX”分布已有人详细推导出埋沟管在各种可能工
MOS管埋沟管在此简单介绍一下埋沟管的IDS计算中的一些问题。由于埋沟管有多种工作状态,情况比表面沟复杂。第二节中已指出,不能以简单地改变开启电压的办法用表面沟公式代替埋沟公式。埋沟管有三种工作状态,即表面反型、表面耗尽和表面积累,而且因为源端和漏端电位不同可以工作在不同的状态,例如可以是源端表面积累而漏端表面耗尽,由此使计算IDS的公式更为复杂。用“BOX”分布已有人详细推导出埋沟管在各种可能工