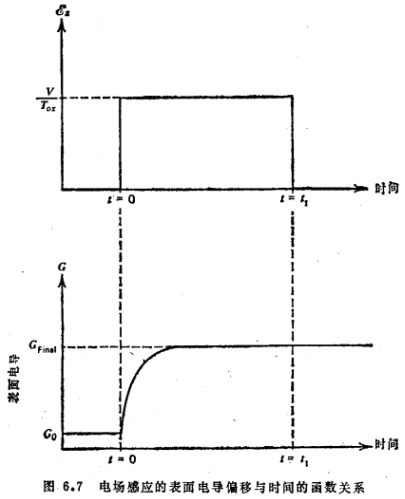
MOS管栅极绝缘物内的离子电导如在2.2.3节所阐明的,栅极绝缘物内一定数量的电荷对MOS器件电特性的影响在很大程度上依赖于电荷相对于硅-二氧化硅界面的空间分布。特别是,位于紧靠界面的电荷将在硅表面附近感生数值相等符号相反的电荷,从而对器件的阈电压或平带电压产生很大的影响。而栅电极附近的电荷对硅表面乃至实测的电特性没有多少影响。因此,假如位于栅极绝缘物内的离子电荷在强电场作用下可以自由运动,则在应
MOS管栅极绝缘物内的离子电导如在2.2.3节所阐明的,栅极绝缘物内一定数量的电荷对MOS器件电特性的影响在很大程度上依赖于电荷相对于硅-二氧化硅界面的空间分布。特别是,位于紧靠界面的电荷将在硅表面附近感生数值相等符号相反的电荷,从而对器件的阈电压或平带电压产生很大的影响。而栅电极附近的电荷对硅表面乃至实测的电特性没有多少影响。因此,假如位于栅极绝缘物内的离子电荷在强电场作用下可以自由运动,则在应
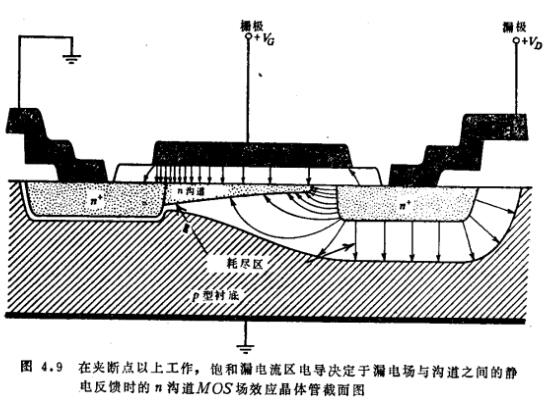
MOS场效应晶体管及其派生器件的电特性,对于γ射线,χ射线和电子辐射十分敏感,易受影响而发生变化。这种电离辐射对MOS器件的全部影响可以分成两大类15~18:1、当器件栅电极上的偏压为正电势或负电势时,在二氧化硅栅极绝缘物内形成正空间电荷区。2、硅-二氧化硅界面上快表面态密度的增加。在栅极绝缘物内产生的正空间电荷,将使MOS电容器的平带电压和MOS晶体管的阈电压向负方向移动,同时漏极电流-栅极电压
MOS场效应晶体管及其派生器件的电特性,对于γ射线,χ射线和电子辐射十分敏感,易受影响而发生变化。这种电离辐射对MOS器件的全部影响可以分成两大类15~18:1、当器件栅电极上的偏压为正电势或负电势时,在二氧化硅栅极绝缘物内形成正空间电荷区。2、硅-二氧化硅界面上快表面态密度的增加。在栅极绝缘物内产生的正空间电荷,将使MOS电容器的平带电压和MOS晶体管的阈电压向负方向移动,同时漏极电流-栅极电压

MOS管热氧化过程中硅内杂质再分布在1960年初,阿塔拉(Atalla)和坦纳鲍姆(Tannenbaum)发现硅衬底表面的杂质掺杂浓度变化是受升高温度热氧化的影响10。后来其他研究者的工作证明,通常用来对硅进行掺杂的几种杂质在氧化过程中再分布的范围和类型有相当大的不同11,12。总之很明显,依赖于硅衬底表面掺杂浓度的MOS器件的电参数是受杂质再分布过程影响的。杂质再分布当然不是硅-二氧化硅系统所独
MOS管热氧化过程中硅内杂质再分布在1960年初,阿塔拉(Atalla)和坦纳鲍姆(Tannenbaum)发现硅衬底表面的杂质掺杂浓度变化是受升高温度热氧化的影响10。后来其他研究者的工作证明,通常用来对硅进行掺杂的几种杂质在氧化过程中再分布的范围和类型有相当大的不同11,12。总之很明显,依赖于硅衬底表面掺杂浓度的MOS器件的电参数是受杂质再分布过程影响的。杂质再分布当然不是硅-二氧化硅系统所独

MOS管高温负偏压不稳定性,虽然MOS器件的单位面积固定正界面电荷密度的数值经过实测表明在-55到+125℃范围内,甚至超出此限而达到250°C,相对来说,往往同温度无关,但是人们发现,当MOS器件在超过300°C的高温环境中工作而且栅极有外加偏压时,表面上的Qss水平会发生移动5,7,9。特别是当有强负偏压加于栅电极时,可以看到表面上的Qss水平增加,结果平带电压向负方向移动。随后再在栅极上施加
MOS管高温负偏压不稳定性,虽然MOS器件的单位面积固定正界面电荷密度的数值经过实测表明在-55到+125℃范围内,甚至超出此限而达到250°C,相对来说,往往同温度无关,但是人们发现,当MOS器件在超过300°C的高温环境中工作而且栅极有外加偏压时,表面上的Qss水平会发生移动5,7,9。特别是当有强负偏压加于栅电极时,可以看到表面上的Qss水平增加,结果平带电压向负方向移动。随后再在栅极上施加

硅-二氧化硅系统固定正界面电荷密度Qss基本特性,一般来说,对于中等掺杂的p型或n型硅进行热氧化时,可以观察到能够分别形成n型表面反型或积累层的明显倾向。许多研究人员发现这一特性的原因是:由于在硅-二氧化硅界面附近存在着固定正电荷密度。用Qss表示的这个单位面积表面态电荷密度在数值上与快表面态电荷密度大不相同,从实用的观点来看它不随外加栅压或界面附近的硅表面电势而变,因为与固定正界面电荷密度相关的
硅-二氧化硅系统固定正界面电荷密度Qss基本特性,一般来说,对于中等掺杂的p型或n型硅进行热氧化时,可以观察到能够分别形成n型表面反型或积累层的明显倾向。许多研究人员发现这一特性的原因是:由于在硅-二氧化硅界面附近存在着固定正电荷密度。用Qss表示的这个单位面积表面态电荷密度在数值上与快表面态电荷密度大不相同,从实用的观点来看它不随外加栅压或界面附近的硅表面电势而变,因为与固定正界面电荷密度相关的
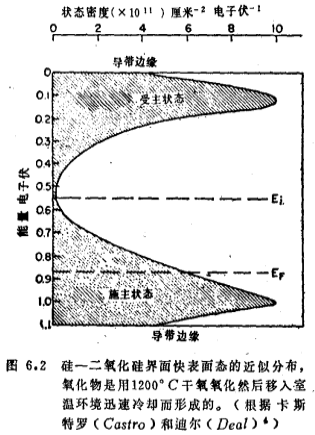
MOS管快表面态在硅-二氧化硅界面上,能量处在硅能带间隙内的表面态通常称为“快表面态”,因为这些状态内的电荷可与硅衬底容易而迅速地进行交换。当在MOS电容器上外加一个电压时,外加栅-衬电势的任何变化可使表面能带弯曲程度相对于硅内的费密能级发生如图6.1所示的变化。因此,如果在界面存在着快表面态,其占据的概率的变化将随外加偏压而变。考虑如图6.1(a)所示的情况,即能量位于或接近带隙中央的快表面态,
MOS管快表面态在硅-二氧化硅界面上,能量处在硅能带间隙内的表面态通常称为“快表面态”,因为这些状态内的电荷可与硅衬底容易而迅速地进行交换。当在MOS电容器上外加一个电压时,外加栅-衬电势的任何变化可使表面能带弯曲程度相对于硅内的费密能级发生如图6.1所示的变化。因此,如果在界面存在着快表面态,其占据的概率的变化将随外加偏压而变。考虑如图6.1(a)所示的情况,即能量位于或接近带隙中央的快表面态,

详解表面态及其对MOS场效应器件电特性的影响分析硅-二氧化硅系统的早期研究表明,氧化物半导体的特性受硅-二氧化硅界面性质的强烈影响,这种影响有时甚至是决定性的。非常明显,从MOS电容器和晶体管所得的实验结果同早期基于理想金属-绝缘体-半导体结构所作的理论研究之间出现的分歧,只有假设存在一个界面电荷密度才能得到解决,与界面电荷密度特性器件的制作工艺密切相关,常常也与外加电压有关。此外,进一步的研究表
详解表面态及其对MOS场效应器件电特性的影响分析硅-二氧化硅系统的早期研究表明,氧化物半导体的特性受硅-二氧化硅界面性质的强烈影响,这种影响有时甚至是决定性的。非常明显,从MOS电容器和晶体管所得的实验结果同早期基于理想金属-绝缘体-半导体结构所作的理论研究之间出现的分歧,只有假设存在一个界面电荷密度才能得到解决,与界面电荷密度特性器件的制作工艺密切相关,常常也与外加电压有关。此外,进一步的研究表

温度变化对MOS场效应晶体管电压特性的影响通常用来表征MOS场效应晶体管电流一电压特性的两个参数是β和VT。特别是,对于一级近似,当外加漏极电压小时,n沟道MOS场效应晶体管的漏电流近似等于而饱和漏电流近似等于注意(4.20)和(4.21)只同β,VT以及外加电压有关。由此可知MOS场效应晶体管电特性随温度而变的任何变化均可直接认为是这两个参数随温度的变化。β是晶体管增益的直接量度,其定义为显而易
温度变化对MOS场效应晶体管电压特性的影响通常用来表征MOS场效应晶体管电流一电压特性的两个参数是β和VT。特别是,对于一级近似,当外加漏极电压小时,n沟道MOS场效应晶体管的漏电流近似等于而饱和漏电流近似等于注意(4.20)和(4.21)只同β,VT以及外加电压有关。由此可知MOS场效应晶体管电特性随温度而变的任何变化均可直接认为是这两个参数随温度的变化。β是晶体管增益的直接量度,其定义为显而易
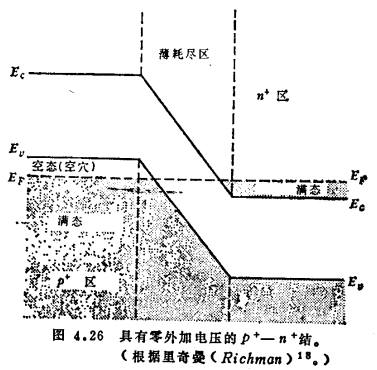
MOS管外加栅压对漏二极管击穿电压影响,在漏结附近高电导电极的存在,对于结的雪崩击穿特性的影响非常明显,由此可告,击穿特性同样受到外加栅极电压变化的强烈影响18。例如对于一个栅极绝缘物相当薄而在雪崩区域工作的n沟道MOS场效应晶体管,在其栅极上外加负电压势必导致栅极和漏电极之间的电位差进一步增大。这个结果将使直接在栅电极下面的硅表面附近的耗尽区内的电场强度有更大的增加。因而,在这个区域内,由于电场
MOS管外加栅压对漏二极管击穿电压影响,在漏结附近高电导电极的存在,对于结的雪崩击穿特性的影响非常明显,由此可告,击穿特性同样受到外加栅极电压变化的强烈影响18。例如对于一个栅极绝缘物相当薄而在雪崩区域工作的n沟道MOS场效应晶体管,在其栅极上外加负电压势必导致栅极和漏电极之间的电位差进一步增大。这个结果将使直接在栅电极下面的硅表面附近的耗尽区内的电场强度有更大的增加。因而,在这个区域内,由于电场

MOS管扩散p-n结邻近对结的导电电极雪崩击穿电压特性的影响在决定MOS场效应晶体管漏区雪崩击穿电压时,最重要的考虑也许是栅电极与耗尽区的接近程度,这里的耗尽区存在于漏扩散区和处在夹断点以上的漏极电压下的沟道区之间。有代表性的是扩散结深为1到3微米范围内的MOS场效应晶体管结构,它的观察漏极雪崩击穿电压要比只考虑结的曲率效应时的预计值低得多,特别是比图4.23所给出的数据要低得多。并已注意到MOS
MOS管扩散p-n结邻近对结的导电电极雪崩击穿电压特性的影响在决定MOS场效应晶体管漏区雪崩击穿电压时,最重要的考虑也许是栅电极与耗尽区的接近程度,这里的耗尽区存在于漏扩散区和处在夹断点以上的漏极电压下的沟道区之间。有代表性的是扩散结深为1到3微米范围内的MOS场效应晶体管结构,它的观察漏极雪崩击穿电压要比只考虑结的曲率效应时的预计值低得多,特别是比图4.23所给出的数据要低得多。并已注意到MOS