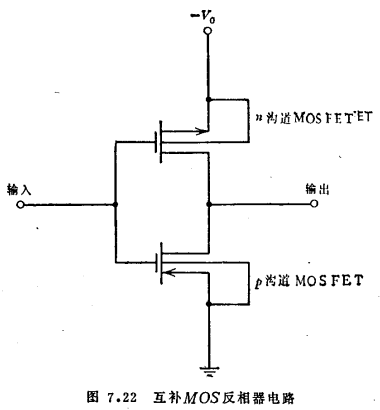
微米沟道长度的自对准离子注入MOS管中载流子速度饱和的影响如7.6.6节所讨论的,香农(Shannon)和比尔(Beale)应用离子注入技术制成了沟道长度极小高频率自对准n沟道绝缘栅 MOS场效应晶体管34。这些器件沟道长度大约等于3微米,显示出了限制器件最高工作频率的载流子速度饱和的影响。最近方(Fang)和克劳德(Crowder)76提出了已经成功地制出和运用了沟道长度为1微米的n沟道增强型离
微米沟道长度的自对准离子注入MOS管中载流子速度饱和的影响如7.6.6节所讨论的,香农(Shannon)和比尔(Beale)应用离子注入技术制成了沟道长度极小高频率自对准n沟道绝缘栅 MOS场效应晶体管34。这些器件沟道长度大约等于3微米,显示出了限制器件最高工作频率的载流子速度饱和的影响。最近方(Fang)和克劳德(Crowder)76提出了已经成功地制出和运用了沟道长度为1微米的n沟道增强型离
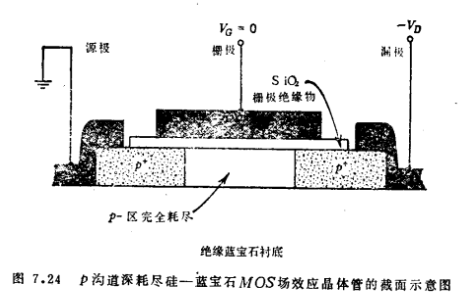
在饱和载流子速度条件下工作的MOS场效应器件的电特性,众所周知,当电场强度非常高时,硅和其它半导体材料的载流子迁移率观测值随电场强度的增加而下降71-73。一般来说,当电场强度很高,载流子在两次碰撞之间被加速到比热运动速度高许多倍的速度时,就会发生上述现象。在这样的条件下,由于载流子的动能比较高,通常称为“热载流子”。一些研究人员指出,当外加电场强度超出临界值时,硅和绪的载流子迁移率是。
在饱和载流子速度条件下工作的MOS场效应器件的电特性,众所周知,当电场强度非常高时,硅和其它半导体材料的载流子迁移率观测值随电场强度的增加而下降71-73。一般来说,当电场强度很高,载流子在两次碰撞之间被加速到比热运动速度高许多倍的速度时,就会发生上述现象。在这样的条件下,由于载流子的动能比较高,通常称为“热载流子”。一些研究人员指出,当外加电场强度超出临界值时,硅和绪的载流子迁移率是。
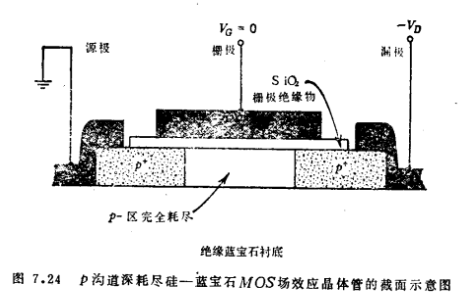
用其它绝缘衬底制作的硅MOS场效应器件作用特性,迄今为止,已经对硅-蓝宝石MOS场效应晶体管进行了大量的研究工作,但是,必须强调,这种工艺的许多优点并不是硅-蓝宝石结构所独有的,利用其它绝缘物作为衬底同样可以得到这些优点。诚然,硅-蓝宝石结构已经取得了极好的结果,制出的器件已向市场供应,而且仍在不断改进和提高。可是,另一方面,利用其它绝缘衬底制成的硅膜MOS场效应晶体管也取得了一些很有希望的结果。
用其它绝缘衬底制作的硅MOS场效应器件作用特性,迄今为止,已经对硅-蓝宝石MOS场效应晶体管进行了大量的研究工作,但是,必须强调,这种工艺的许多优点并不是硅-蓝宝石结构所独有的,利用其它绝缘物作为衬底同样可以得到这些优点。诚然,硅-蓝宝石结构已经取得了极好的结果,制出的器件已向市场供应,而且仍在不断改进和提高。可是,另一方面,利用其它绝缘衬底制成的硅膜MOS场效应晶体管也取得了一些很有希望的结果。
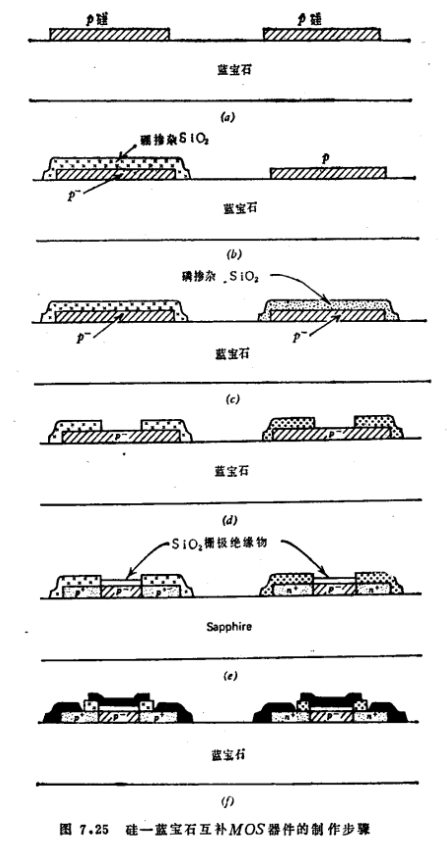
互补硅-蓝宝石MOS场效应晶体管已经表明,在同一块P型硅-蓝宝石薄膜上,可以同时制成n和P沟道(深耗尽)MOS场效应晶体管。如果硅膜的电阻率和厚度以及二氧化硅界面的单位面积固定正电荷密度Qss选择合适,可以满足式(7.34),而且,在零栅电压条件下,硅表面既不形成P型积累层,又不形成n型反型层,那么应用硅-蓝宝石技术,即可在同一块硅片上同时制成互补n和P沟道MOS增强型器件。艾利森(Allison
互补硅-蓝宝石MOS场效应晶体管已经表明,在同一块P型硅-蓝宝石薄膜上,可以同时制成n和P沟道(深耗尽)MOS场效应晶体管。如果硅膜的电阻率和厚度以及二氧化硅界面的单位面积固定正电荷密度Qss选择合适,可以满足式(7.34),而且,在零栅电压条件下,硅表面既不形成P型积累层,又不形成n型反型层,那么应用硅-蓝宝石技术,即可在同一块硅片上同时制成互补n和P沟道MOS增强型器件。艾利森(Allison
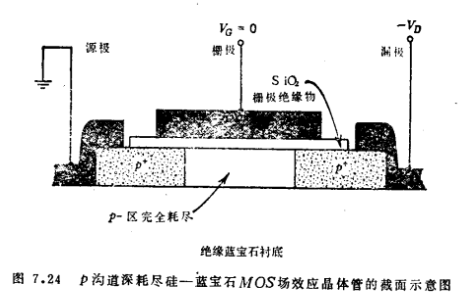
分析P+P-P+深耗尽型硅-蓝宝石MOS场效应晶体管特性 由于硅-蓝宝石MOS场效应晶体管的薄膜性质,霍夫斯泰因(Hofstein)57和海曼(Heiman)58发现:在高电阻率P型硅-蓝宝石薄膜上扩散P+漏区和源区有可能制成“无结”增强型器件。如图7.24所示,如果硅薄膜电阻率足够高,而且硅膜足够薄,则栅源电压为零时,表面耗尽区可以通过硅一直扩展到蓝宝石衬底。因此,漏区和源区之间电导被切断的方式
分析P+P-P+深耗尽型硅-蓝宝石MOS场效应晶体管特性 由于硅-蓝宝石MOS场效应晶体管的薄膜性质,霍夫斯泰因(Hofstein)57和海曼(Heiman)58发现:在高电阻率P型硅-蓝宝石薄膜上扩散P+漏区和源区有可能制成“无结”增强型器件。如图7.24所示,如果硅薄膜电阻率足够高,而且硅膜足够薄,则栅源电压为零时,表面耗尽区可以通过硅一直扩展到蓝宝石衬底。因此,漏区和源区之间电导被切断的方式
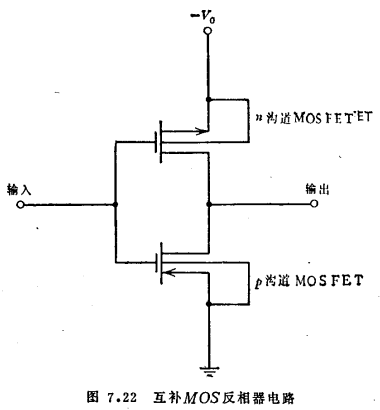
硅-蓝宝石MOS场效应器件·的作用和性能分析为了发展速度更高的MOS器件和集成电路所进行的大量探索性工作,主要是集中在制作栅-漏和栅-源寄生电容非常小的器件上,可是,必须记住,通过降低寄生结电容和对衬底的寄生互连电容,也可以大大改善高速性能。这一点可采用硅-蓝宝石MOS器件来实现。·简称SOS MOS场效应器件—译者注1964年马纳塞维特(Manasevit)和辛普森(Simpson)54证明,在
硅-蓝宝石MOS场效应器件·的作用和性能分析为了发展速度更高的MOS器件和集成电路所进行的大量探索性工作,主要是集中在制作栅-漏和栅-源寄生电容非常小的器件上,可是,必须记住,通过降低寄生结电容和对衬底的寄生互连电容,也可以大大改善高速性能。这一点可采用硅-蓝宝石MOS器件来实现。·简称SOS MOS场效应器件—译者注1964年马纳塞维特(Manasevit)和辛普森(Simpson)54证明,在
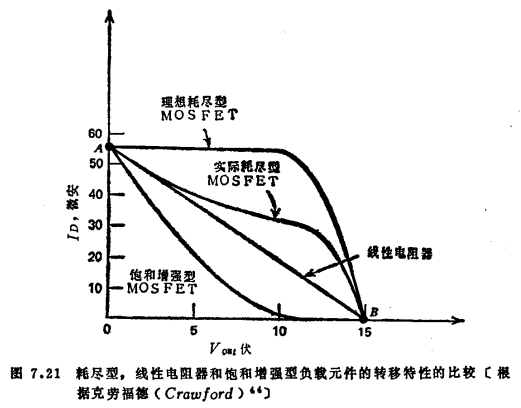
应用离子注入技术改变MOS场效应器件的观测阈电压虽然,制作MOS场效应晶体管和集成电路,最先应用离子注入技术的目的是用栅电极作为掩模,以减小寄生的栅-漏和栅-源电容,而且还注入与再现高表面电阻率的线性电阻。不久就显而易见利用离子注入技术来改变MOS场效应晶体管的阈电压也许是更为重要的应用。特别是,人们发现,只要穿过器件栅极绝缘物对其下的硅衬底注入浓度比较低的受主或施主杂质,就可以改变n或P沟道MO
应用离子注入技术改变MOS场效应器件的观测阈电压虽然,制作MOS场效应晶体管和集成电路,最先应用离子注入技术的目的是用栅电极作为掩模,以减小寄生的栅-漏和栅-源电容,而且还注入与再现高表面电阻率的线性电阻。不久就显而易见利用离子注入技术来改变MOS场效应晶体管的阈电压也许是更为重要的应用。特别是,人们发现,只要穿过器件栅极绝缘物对其下的硅衬底注入浓度比较低的受主或施主杂质,就可以改变n或P沟道MO
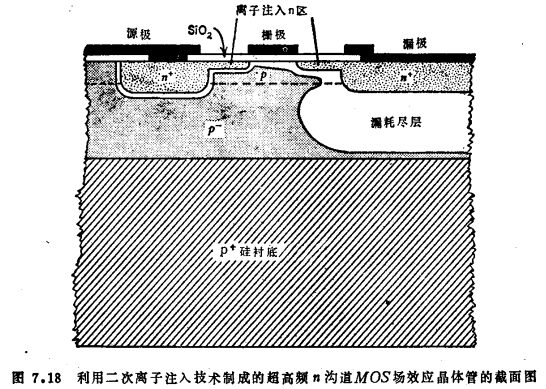
解析利用离子注入技术制作自对准栅极MOS 场效应晶体管和集成电路佣栅和硅栅结构都是依靠栅电极本身作为势垒,以阻挡杂质对MOS场效应晶体管有源沟道区的扩散。然而,假如采用扩散和离子注入的综合技术来构成漏区和源区,利用栅电极作为掩模以保护下面的沟道区在注入过程中免受高能杂质离子的辐射,就可以制出自对准MOS场效应晶体管结构。用此方法制作的分立器件和集成电路的寄生栅一漏和栅一源电容极小,实际上远远
解析利用离子注入技术制作自对准栅极MOS 场效应晶体管和集成电路佣栅和硅栅结构都是依靠栅电极本身作为势垒,以阻挡杂质对MOS场效应晶体管有源沟道区的扩散。然而,假如采用扩散和离子注入的综合技术来构成漏区和源区,利用栅电极作为掩模以保护下面的沟道区在注入过程中免受高能杂质离子的辐射,就可以制出自对准MOS场效应晶体管结构。用此方法制作的分立器件和集成电路的寄生栅一漏和栅一源电容极小,实际上远远
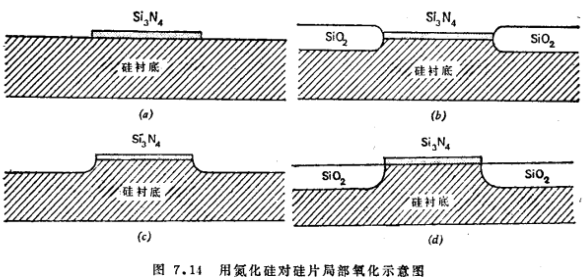
硅栅MOS管和MOS集成电路,利用与制作钼栅MOS场效应晶体管非常相似的工艺技术,使淀积的多晶硅材料也可用来形成自对准MOS场效应晶体管的栅电极。淀积在二氧化硅薄绝缘层上的多晶硅薄膜,对于硼或磷杂质向下面的硅衬底作局部扩散来说如同一个有效势垒的作用。同时,淀积的多晶硅电极也是重掺杂的,并有足够高的电导率,除了用来作为接触以外,都不覆盖金属。在扩散的时候,多晶硅与下面的二氧化硅被腐蚀掉的地方,就形成
硅栅MOS管和MOS集成电路,利用与制作钼栅MOS场效应晶体管非常相似的工艺技术,使淀积的多晶硅材料也可用来形成自对准MOS场效应晶体管的栅电极。淀积在二氧化硅薄绝缘层上的多晶硅薄膜,对于硼或磷杂质向下面的硅衬底作局部扩散来说如同一个有效势垒的作用。同时,淀积的多晶硅电极也是重掺杂的,并有足够高的电导率,除了用来作为接触以外,都不覆盖金属。在扩散的时候,多晶硅与下面的二氧化硅被腐蚀掉的地方,就形成
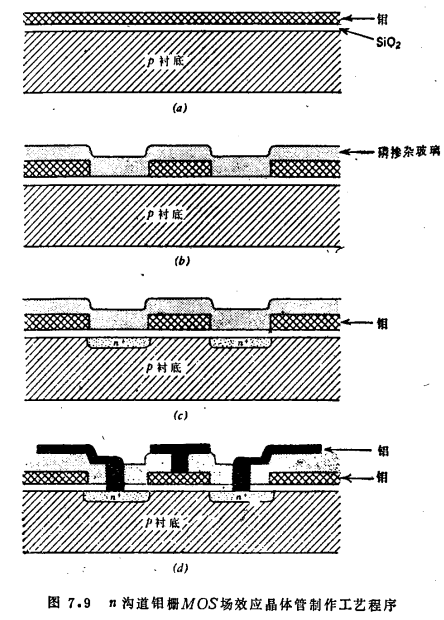
钼栅自对准MOS场效应晶体管及其制作工艺程序,由于钼的电导率比较高,可以用来形成绝缘栅极场效应晶体管的栅电极。不过,它不像铝那样能够在磷或硼向硅内扩散掺杂时的温度便可熔解,钼是难熔金属,熔点近似等于2600°C,而且对这两种掺杂剂都是有效的扩散掩模。由于钼具有这些性质,钼栅极可以当作扩散势垒用以确定MOS场效应晶体管的源区和漏区的位置,对于这些区就形成了能够自动对准的栅电极。
钼栅自对准MOS场效应晶体管及其制作工艺程序,由于钼的电导率比较高,可以用来形成绝缘栅极场效应晶体管的栅电极。不过,它不像铝那样能够在磷或硼向硅内扩散掺杂时的温度便可熔解,钼是难熔金属,熔点近似等于2600°C,而且对这两种掺杂剂都是有效的扩散掩模。由于钼具有这些性质,钼栅极可以当作扩散势垒用以确定MOS场效应晶体管的源区和漏区的位置,对于这些区就形成了能够自动对准的栅电极。