
MOS管器件衬底偏压对漏源电导的影响,施加到MOSFET衬底上的电压对于器件的漏源I-V特性影响很大。从这点意义上来,衬底可以当作控制漏-源电导的第二个栅极。但是,衬底偏压对于I-V曲线的影响程度随着偏压及其衬底电阻率的数值不同而不同。要是N-沟道元件加上负的衬底电压,而P-沟道元件加上正的衬底电压,那么,对于各种栅压而言,其漏-源之间的电导率将减小,而阈值电压则相应地增大。漏-源电导率的减小可以
MOS管器件衬底偏压对漏源电导的影响,施加到MOSFET衬底上的电压对于器件的漏源I-V特性影响很大。从这点意义上来,衬底可以当作控制漏-源电导的第二个栅极。但是,衬底偏压对于I-V曲线的影响程度随着偏压及其衬底电阻率的数值不同而不同。要是N-沟道元件加上负的衬底电压,而P-沟道元件加上正的衬底电压,那么,对于各种栅压而言,其漏-源之间的电导率将减小,而阈值电压则相应地增大。漏-源电导率的减小可以

MOS管夹断和饱和区,假使加到绝缘栅MOSFE的漏-源电压增大到使漏极近穿的那部分绝缘层具有足够小的电位差,那么在此绝缘层下面沟道就形成了耗尽区。这也是在第三章定义夹断电压时得到的结果。当VD=VG-VP时,夹断就发生了。VD>VG-VP但未越入雪崩击穿区的范围均为区2,即饱和区。因此,对于每个栅极电压,得到饱和所要求的漏-源电压是不同的。在夹断时,漏极沟道上的绝缘层,其电场强度非常之小,以至于漏
MOS管夹断和饱和区,假使加到绝缘栅MOSFE的漏-源电压增大到使漏极近穿的那部分绝缘层具有足够小的电位差,那么在此绝缘层下面沟道就形成了耗尽区。这也是在第三章定义夹断电压时得到的结果。当VD=VG-VP时,夹断就发生了。VD>VG-VP但未越入雪崩击穿区的范围均为区2,即饱和区。因此,对于每个栅极电压,得到饱和所要求的漏-源电压是不同的。在夹断时,漏极沟道上的绝缘层,其电场强度非常之小,以至于漏

MOS管器件夹断之前可调电阻区的导电情况正象我们看到的那样,在MOS晶体管中,漏和源之间的电导是栅极电压的函数。实质上,这是沟道电阻随栅压而变化的结果。对于漏源电压比较小而低于夹断的情,漏和源之间的电流通道仅仅由导电材料所构成·然而,漏源电压较高时,在漏区附近便开始形成耗尽区,从而把沟道夹断。漏源电压进一步增大,电流就发生饱和,而器件就工作于区2。如果我们来考虑漏-源电压较低,好象VD VG-V
MOS管器件夹断之前可调电阻区的导电情况正象我们看到的那样,在MOS晶体管中,漏和源之间的电导是栅极电压的函数。实质上,这是沟道电阻随栅压而变化的结果。对于漏源电压比较小而低于夹断的情,漏和源之间的电流通道仅仅由导电材料所构成·然而,漏源电压较高时,在漏区附近便开始形成耗尽区,从而把沟道夹断。漏源电压进一步增大,电流就发生饱和,而器件就工作于区2。如果我们来考虑漏-源电压较低,好象VD VG-V
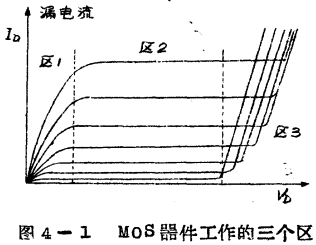
解析MOS管特性划分为三个工作区的基本特征,对于典型的MOS晶体管,当以漏电流对漏-源电压作图,其特性曲线-栅极电压作为曲线的参变量-首先呈线性地增大,随后趋于平坦,最后又迅猛地增大。MOS管三个区。因而MOS晶体管的电学特性可以划分为三个不同的区域,具体情如图4-1所示。三个区的导电机构是不同的,每个区都要分别加以描绘。区域1称为三极管区或者叫可调电阻区。区域2称为饱和电流区或者统称为饱和区,区
解析MOS管特性划分为三个工作区的基本特征,对于典型的MOS晶体管,当以漏电流对漏-源电压作图,其特性曲线-栅极电压作为曲线的参变量-首先呈线性地增大,随后趋于平坦,最后又迅猛地增大。MOS管三个区。因而MOS晶体管的电学特性可以划分为三个不同的区域,具体情如图4-1所示。三个区的导电机构是不同的,每个区都要分别加以描绘。区域1称为三极管区或者叫可调电阻区。区域2称为饱和电流区或者统称为饱和区,区

如果以微分的形式和相应的电磁边界条件来研究麦克斯韦方程,表面场效应的物理基础就极为显然了。下面一个方程可能是电磁理论中最为基本的定律,可见,电位移矢量的散度等于单位体积的电荷密度。这个定律在讨论材料体内的任何一点时都是适用的。不过在两种不同材料的界面或者样品的表面都可能有电荷存在,这就致使电场变成不连续的。为了妥善地处理这个问题,必须利用其电磁边界条件。显而易见,在图2-3中,区域1和2之间的界面
如果以微分的形式和相应的电磁边界条件来研究麦克斯韦方程,表面场效应的物理基础就极为显然了。下面一个方程可能是电磁理论中最为基本的定律,可见,电位移矢量的散度等于单位体积的电荷密度。这个定律在讨论材料体内的任何一点时都是适用的。不过在两种不同材料的界面或者样品的表面都可能有电荷存在,这就致使电场变成不连续的。为了妥善地处理这个问题,必须利用其电磁边界条件。显而易见,在图2-3中,区域1和2之间的界面

MOS场效应管沟道中有效迁移率随栅压而变化的情况,在推导MOSFET的电学特性中,开始假定沟道中载流子的迁移率不是外加-衬底电压的函数。但是,这种假定并非完全正确,特别是栅压很低或者很高时会有一定的偏差。一般地,迁移率恒定的假设,其正确的程度如何是与硅-绝缘层界面的物理结构有关。如果硅-绝缘层的交界面上有许多表面陷阱状态,低栅压时,沟道中载流子的迁移率就会显著地减小。这种影响是很容易理解的。倘若栅
MOS场效应管沟道中有效迁移率随栅压而变化的情况,在推导MOSFET的电学特性中,开始假定沟道中载流子的迁移率不是外加-衬底电压的函数。但是,这种假定并非完全正确,特别是栅压很低或者很高时会有一定的偏差。一般地,迁移率恒定的假设,其正确的程度如何是与硅-绝缘层界面的物理结构有关。如果硅-绝缘层的交界面上有许多表面陷阱状态,低栅压时,沟道中载流子的迁移率就会显著地减小。这种影响是很容易理解的。倘若栅

半导体的扩散电流,虽然在MOS晶体管中,主要是由漂移而引起电流的流动,其他导电机构我们也要扼要地加以说明。至此提到的方程式未考虑由于载流子分布的不均匀性而引想的扩散电流。电流密度image.png仅由漂移而产生,其前提为样品中空穴和导带电子的分布到处都是均匀的。当这些载流子分布不均匀时,就存在着载流子的濃度梯度,从而产生扩散电流。
半导体的扩散电流,虽然在MOS晶体管中,主要是由漂移而引起电流的流动,其他导电机构我们也要扼要地加以说明。至此提到的方程式未考虑由于载流子分布的不均匀性而引想的扩散电流。电流密度image.png仅由漂移而产生,其前提为样品中空穴和导带电子的分布到处都是均匀的。当这些载流子分布不均匀时,就存在着载流子的濃度梯度,从而产生扩散电流。
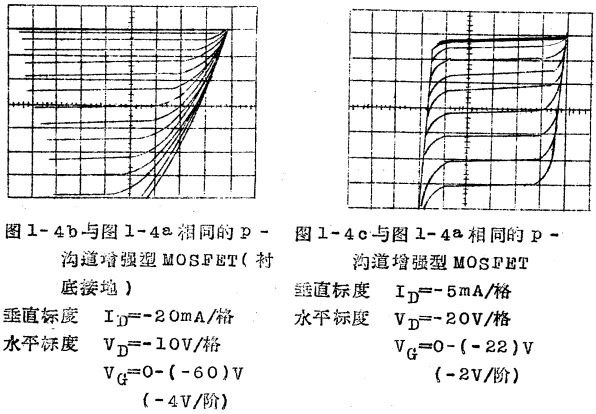
半导体的漂移电流电流的意义就是单位时间内电荷通过某处而运动。此电荷可以是电子,也可以是空穴。暂且只用电子来考虑电流的流动。空穴电流则可仿效时论。倘若电子电流在半导体中流动,可以认为,所有的电子都具有确定的平均速率。在体内,欧姆定律为式中电流密度可定义为单位时间单位面积所流过的电荷量。因而式中n为单位体积材料中参与导电电子的数目,而e为电子的电荷量。如果对半导体中的电子施加电场,由于静电力的作用,每
半导体的漂移电流电流的意义就是单位时间内电荷通过某处而运动。此电荷可以是电子,也可以是空穴。暂且只用电子来考虑电流的流动。空穴电流则可仿效时论。倘若电子电流在半导体中流动,可以认为,所有的电子都具有确定的平均速率。在体内,欧姆定律为式中电流密度可定义为单位时间单位面积所流过的电荷量。因而式中n为单位体积材料中参与导电电子的数目,而e为电子的电荷量。如果对半导体中的电子施加电场,由于静电力的作用,每

“金属-氧化物-半导体场效应晶体管”不要误称为“晶体管”虽然MOSFET是一种能起电压和功率放大的三端有源器件,但它却完全不同于通常的p-n结晶体管。MOS晶体管是一种电压控制的器件,其工作取决于电场效应。MOS效应晶体管有两种完全不同的类型。N-型沟道的元件依电子的电导而工作,而P-型沟道元件的工作则依赖于穴的电导。我们只考虑N-型沟道的晶体管,而P-型沟道的器件可以仿效时论。N-型沟道MOS晶
“金属-氧化物-半导体场效应晶体管”不要误称为“晶体管”虽然MOSFET是一种能起电压和功率放大的三端有源器件,但它却完全不同于通常的p-n结晶体管。MOS晶体管是一种电压控制的器件,其工作取决于电场效应。MOS效应晶体管有两种完全不同的类型。N-型沟道的元件依电子的电导而工作,而P-型沟道元件的工作则依赖于穴的电导。我们只考虑N-型沟道的晶体管,而P-型沟道的器件可以仿效时论。N-型沟道MOS晶
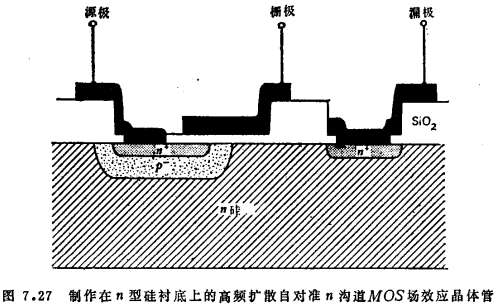
解析制作微米沟道长度MOS场效应晶体管的扩散-自对准技术,哈里斯(Harries)76首次提出并成功地证实应用扩散-自对准结构的概念制作有效沟道长度约为1-2微米的n沟道增强型MOS场效应晶体管。哈里斯(Harries)在高电阻率p型硅衬底上制作了这种器件,方法是首先局部腐蚀二氧化硅掩模层,为源扩散确定窗口,在完成低浓度p型(硼)扩散之后,随着进行延时驱进,以降低硅表面的有效掺杂浓度,和在除了源区
解析制作微米沟道长度MOS场效应晶体管的扩散-自对准技术,哈里斯(Harries)76首次提出并成功地证实应用扩散-自对准结构的概念制作有效沟道长度约为1-2微米的n沟道增强型MOS场效应晶体管。哈里斯(Harries)在高电阻率p型硅衬底上制作了这种器件,方法是首先局部腐蚀二氧化硅掩模层,为源扩散确定窗口,在完成低浓度p型(硼)扩散之后,随着进行延时驱进,以降低硅表面的有效掺杂浓度,和在除了源区