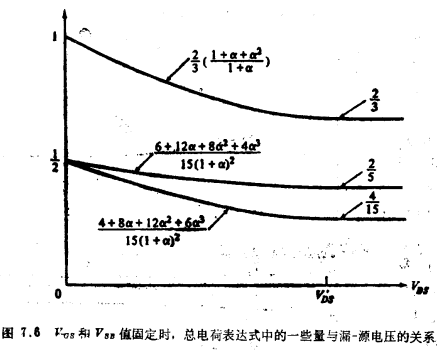
MOS晶体管准静态工作下电荷计算的中反型特征与建立漏端电流模型时的情况一样,在中反型区,未曾导出过简便的闭式的电荷表达式。建立电荷模型的通常的做法是忽略这个区域,而假设弱反型和强反型表达式所适用的VGS值的区域是紧挨的。这两个区域之间的分界,点常常取为,即VM(中反型区底部)的近似值。这样做对中反型区的电荷所引起的误差是不大的。然而,若企图通过对这些电荷求微分来获得电容表达式,则我们将会看到,产生
MOS晶体管准静态工作下电荷计算的中反型特征与建立漏端电流模型时的情况一样,在中反型区,未曾导出过简便的闭式的电荷表达式。建立电荷模型的通常的做法是忽略这个区域,而假设弱反型和强反型表达式所适用的VGS值的区域是紧挨的。这两个区域之间的分界,点常常取为,即VM(中反型区底部)的近似值。这样做对中反型区的电荷所引起的误差是不大的。然而,若企图通过对这些电荷求微分来获得电容表达式,则我们将会看到,产生
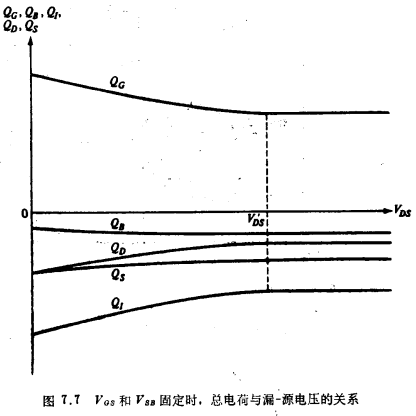
MOS晶体管强反型准静态工作下电荷的计算分析在准静态工作假没下(7.2节),可直接推导出计算式(7.3.16)中的充电电流所需的电荷表达式。在此假设下,我们可观察到,用υG(t)、υB(t),υS(t)和υD(t)来表示的qG(t)、qB(t)、qI(t),qD和qS(t)的表达式与直流条件下用直流电压VG,VB、VS和VD所表示的电荷QG、QB、QI、QD和QS的表达式是相同的,后者已在式(7.
MOS晶体管强反型准静态工作下电荷的计算分析在准静态工作假没下(7.2节),可直接推导出计算式(7.3.16)中的充电电流所需的电荷表达式。在此假设下,我们可观察到,用υG(t)、υB(t),υS(t)和υD(t)来表示的qG(t)、qB(t)、qI(t),qD和qS(t)的表达式与直流条件下用直流电压VG,VB、VS和VD所表示的电荷QG、QB、QI、QD和QS的表达式是相同的,后者已在式(7.
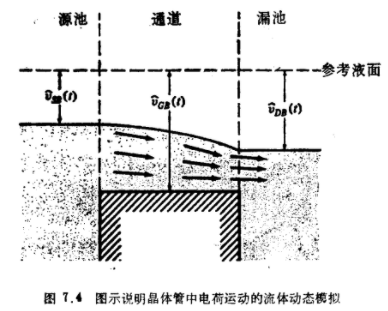
MOS晶体管准静态工作时的端电流准静态工作时的端电流假设图7.3所示的理想化器件处于准静态工作,现在来计算其端电流(真实器件的总的端电流还要包括非本征区寄生电容引起的电流分量。假设没有栅“泄漏”,因此不存在栅传输电流,图7.3中的全部栅电流与栅电荷的变化有关:与此类似,假设器件体内无泄漏,则耗尽区中的传输电流为零。那么总的体电流与耗尽区中的载流子有关,载流子电荷随该区中空穴的耗尽或“补充”而变化:
MOS晶体管准静态工作时的端电流准静态工作时的端电流假设图7.3所示的理想化器件处于准静态工作,现在来计算其端电流(真实器件的总的端电流还要包括非本征区寄生电容引起的电流分量。假设没有栅“泄漏”,因此不存在栅传输电流,图7.3中的全部栅电流与栅电荷的变化有关:与此类似,假设器件体内无泄漏,则耗尽区中的传输电流为零。那么总的体电流与耗尽区中的载流子有关,载流子电荷随该区中空穴的耗尽或“补充”而变化:
准静态工作考虑图7.2所示的一虚构器件,为了强调只研究器件的本征部分,图中略去了源和漏。这器件由四个直流电压VD、VG、VB和VS驱动,这些电压定义为相对于用接地符号表示的任意参考点。四个直流电流ID、IG、IB和IS定义为流进器件,如图所示。我们已知,电流的流动是由反型层中电子的传输引起的(假定是n沟器件),若定义传输电流(或称“传导”电流)的流动是由漏经沟道到源,并用IT表示,则有这里略去了绝
准静态工作考虑图7.2所示的一虚构器件,为了强调只研究器件的本征部分,图中略去了源和漏。这器件由四个直流电压VD、VG、VB和VS驱动,这些电压定义为相对于用接地符号表示的任意参考点。四个直流电流ID、IG、IB和IS定义为流进器件,如图所示。我们已知,电流的流动是由反型层中电子的传输引起的(假定是n沟器件),若定义传输电流(或称“传导”电流)的流动是由漏经沟道到源,并用IT表示,则有这里略去了绝
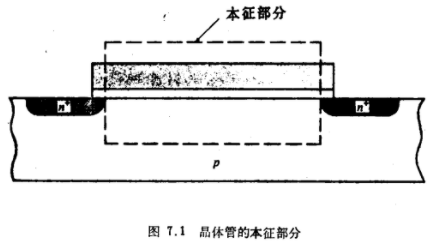
动作工作下的MOS晶体管-大信号建模作用在假设所有端电压均为常数的情况下分析了MOS晶体管。然而,这种器件通常用于端电压是变化的电路。这种“动态”工作引起晶体管电荷的变化,而这些电荷的变化必须由外部流罕器件各端的额外电流来提供(这里“额外 是指不是由直流理论所预测的电流)。本章的主题是:计算动态工作下的各种电荷和各端电流,而对各个变量的大小不作限制,即讨论大信号动态工作下的MOS晶体管。我们将着重
动作工作下的MOS晶体管-大信号建模作用在假设所有端电压均为常数的情况下分析了MOS晶体管。然而,这种器件通常用于端电压是变化的电路。这种“动态”工作引起晶体管电荷的变化,而这些电荷的变化必须由外部流罕器件各端的额外电流来提供(这里“额外 是指不是由直流理论所预测的电流)。本章的主题是:计算动态工作下的各种电荷和各端电流,而对各个变量的大小不作限制,即讨论大信号动态工作下的MOS晶体管。我们将着重
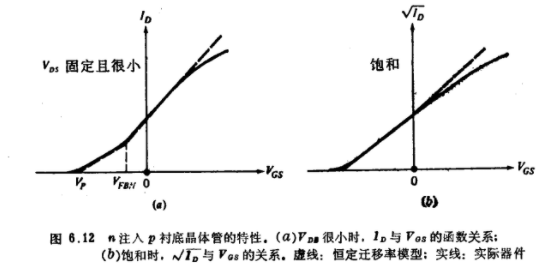
与衬底反型的注入MOS晶体管工作器件特性现在我们来考虑图6.10所示的一个完整的晶体管,并设VDBVSB(VDS0)。用VCB表示沟道中性部分处的一点与非注入衬底之间的有效反向偏压。这样,我们便能直接应用上面导出的公式。VCB的值从源端的VSB增加到漏端的VDB。因此,np结的耗尽区将从源到漏逐渐变深。根据端电压相对值的不同,可以区分为几个工作区,下面对它们进行讨论。首先假定埋沟存在于源的旁边;根
与衬底反型的注入MOS晶体管工作器件特性现在我们来考虑图6.10所示的一个完整的晶体管,并设VDBVSB(VDS0)。用VCB表示沟道中性部分处的一点与非注入衬底之间的有效反向偏压。这样,我们便能直接应用上面导出的公式。VCB的值从源端的VSB增加到漏端的VDB。因此,np结的耗尽区将从源到漏逐渐变深。根据端电压相对值的不同,可以区分为几个工作区,下面对它们进行讨论。首先假定埋沟存在于源的旁边;根
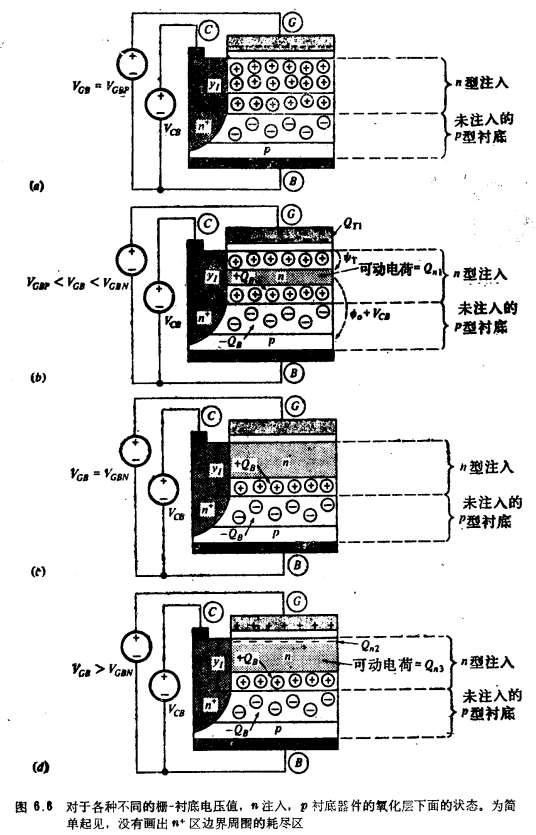
与衬底反型的注入沟道MOS晶体管的电荷及临界电压电荷及临界电压现在考虑p型衬底,n型注入的器件。在所有的注入离子(施主)最终都留在表面这样一种假设下,这些离子只是是使单位面积有效界面电荷Q´o改变了(+q)M,其中M是有效剂量;因此VTO下移qM/Q´o。然而更实际一些地说,注入的分布看来还是如图6.2a所示。这一分布上还是用6.2b来近似[这里N()和NI表示施主浓度]。当NINAB时,表面和之
与衬底反型的注入沟道MOS晶体管的电荷及临界电压电荷及临界电压现在考虑p型衬底,n型注入的器件。在所有的注入离子(施主)最终都留在表面这样一种假设下,这些离子只是是使单位面积有效界面电荷Q´o改变了(+q)M,其中M是有效剂量;因此VTO下移qM/Q´o。然而更实际一些地说,注入的分布看来还是如图6.2a所示。这一分布上还是用6.2b来近似[这里N()和NI表示施主浓度]。当NINAB时,表面和之

简易与衬底同型的注入沟道MOS晶体管特性作用从上述讨论应该清楚地看出,如果离子注入的剂量大且又不是浅注入,则会出现若干有害效应。这些有害效应包括低VSB时的强体效应,VGS和VSB值较小时ΔID/ΔVGS的衰减,弱反型时失去指数特性以及截止较慢等等。因此被注入的离子应该保持其能量为最小(但又必须足以保证使离子最终到达半导体而不是氧化层),同时还要避免高温处理,以防止离子向内散布。然而,从穿通角度来
简易与衬底同型的注入沟道MOS晶体管特性作用从上述讨论应该清楚地看出,如果离子注入的剂量大且又不是浅注入,则会出现若干有害效应。这些有害效应包括低VSB时的强体效应,VGS和VSB值较小时ΔID/ΔVGS的衰减,弱反型时失去指数特性以及截止较慢等等。因此被注入的离子应该保持其能量为最小(但又必须足以保证使离子最终到达半导体而不是氧化层),同时还要避免高温处理,以防止离子向内散布。然而,从穿通角度来

与衬底弱同型的注入沟道MOS晶体管特性现在,让我们简单地看一下弱反型特性。ID与VGS的关系曲线看来如图6.7所示。对于较大的VSB,耗尽区的边在注入区之外,器件特性与非注入器件的特性定性相似。斜率和以前一样,正比于1/n,n由式(4.6.20)给山,γ=γ2,且由式(6.2.11)给出。但是,对于较小的VSB,耗尽区的边在注入区之内,γ=γ1,并由式(6.2.4)给出,因而n就大,斜率就小。对于
与衬底弱同型的注入沟道MOS晶体管特性现在,让我们简单地看一下弱反型特性。ID与VGS的关系曲线看来如图6.7所示。对于较大的VSB,耗尽区的边在注入区之外,器件特性与非注入器件的特性定性相似。斜率和以前一样,正比于1/n,n由式(4.6.20)给山,γ=γ2,且由式(6.2.11)给出。但是,对于较小的VSB,耗尽区的边在注入区之内,γ=γ1,并由式(6.2.4)给出,因而n就大,斜率就小。对于

分析与衬底同型的注入分段二次强反型模型我们可以对电流公式进行简化,从而导出—个与式(4.4.30)有关的近似模型。利用类似于导出式(4.4.30)的方法,或者干脆直接通过式(6.2.27)的一种适当的展开式,便可得到这种简化模型。但是,这里必须使用两个不同的δ参数:与注入区有关的δ1和与非注入衬底有关的δ2。详细过程概括在题6.2的说明中。我们发现,在这样一种模型中,重又得到了下面形式的非饱和的电
分析与衬底同型的注入分段二次强反型模型我们可以对电流公式进行简化,从而导出—个与式(4.4.30)有关的近似模型。利用类似于导出式(4.4.30)的方法,或者干脆直接通过式(6.2.27)的一种适当的展开式,便可得到这种简化模型。但是,这里必须使用两个不同的δ参数:与注入区有关的δ1和与非注入衬底有关的δ2。详细过程概括在题6.2的说明中。我们发现,在这样一种模型中,重又得到了下面形式的非饱和的电